Semiconductor Technology Introduction
ContentsList of Figures VIIList of Tables XI1 Fundamentals 11.1 The atomic structure . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 11.1.1 The atomic model . . . . . . . . . . . . .
预览截图
应用介绍
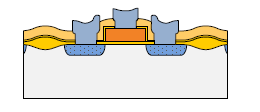
Contents
List of Figures VIIList of Tables XI
1 Fundamentals 1
1.1 The atomic structure . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 1
1.1.1 The atomic model . . . . . . . . . . . . . . . . . . . . . . . . . . . . 1
1.1.2 Properties of atoms . . . . . . . . . . . . . . . . . . . . . . . . . . . 2
1.2 The elements, the periodic table . . . . . . . . . . . . . . . . . . . . . . . . 3
1.2.1 Elements . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 3
1.2.2 The periodic table of the chemical elements . . . . . . . . . . . . . 3
1.3 Chemical bonds . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 4
1.3.1 Chemical bonds . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 4
1.3.2 The atomic bond . . . . . . . . . . . . . . . . . . . . . . . . . . . . 5
1.3.3 The ionic bond . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 6
1.3.4 The metallic bonding . . . . . . . . . . . . . . . . . . . . . . . . . . 6
1.3.5 Intermolecular bondings . . . . . . . . . . . . . . . . . . . . . . . . 7
1.4 Noble gases . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 8
1.5 Conductors - Insulators - Semiconductors . . . . . . . . . . . . . . . . . . 9
1.5.1 Conductors . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 9
1.5.2 Insulators . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 10
1.5.3 Semiconductors . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 10
1.5.4 The band model . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 11
1.6 Doping: n- and p-semiconductors . . . . . . . . . . . . . . . . . . . . . . . 14
1.6.1 Doping . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 14
1.6.2 n-doping . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 14
1.6.3 p-doping . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 15
1.6.4 Electronic band structure in doped semiconductors . . . . . . . . 16
I
Contents
1.7 The p-n junction . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 17
1.7.1 p-n junction at thermal equilibrium . . . . . . . . . . . . . . . . . 17
1.7.2 p-n junction with external applied voltage . . . . . . . . . . . . . 18
1.8 Field-effect transistors . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 19
1.8.1 General layout . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 19
1.8.2 Construction of a n-channel FET . . . . . . . . . . . . . . . . . . . 20
1.8.3 Mode of operation . . . . . . . . . . . . . . . . . . . . . . . . . . . 25
1.9 Bipolar transistors . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 26
1.9.1 General layout . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 26
1.9.2 Construction of an NPN bipolar transistor . . . . . . . . . . . . . 27
1.9.3 Mode of operation . . . . . . . . . . . . . . . . . . . . . . . . . . . 29
1.10 Construction of a FinFET . . . . . . . . . . . . . . . . . . . . . . . . . . . . 30
1.10.1 General layout and mode of operation . . . . . . . . . . . . . . . . 30
1.10.2 Construction of a bulk silicon-based FinFET . . . . . . . . . . . . 30
2 Wafer fabrication 33
2.1 Properties of silicon . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 33
2.2 Raw silicon . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 34
2.2.1 Production of raw silicon . . . . . . . . . . . . . . . . . . . . . . . 34
2.2.2 Purification of the raw silicon . . . . . . . . . . . . . . . . . . . . . 34
2.2.3 Zone cleaning . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 35
2.3 Fabrication of the single crystal . . . . . . . . . . . . . . . . . . . . . . . . 36
2.3.1 The single crystal . . . . . . . . . . . . . . . . . . . . . . . . . . . . 36
2.3.2 Czochralski process . . . . . . . . . . . . . . . . . . . . . . . . . . 36
2.3.3 Float-zone silicon . . . . . . . . . . . . . . . . . . . . . . . . . . . . 38
2.4 Wafer fabrication . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 38
2.4.1 Wafer separation and surface refinement . . . . . . . . . . . . . . 38
2.4.2 Historical development of the wafer size . . . . . . . . . . . . . . 40
2.5 Doping techniques . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 41
2.5.1 Definition . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 41
2.5.2 Diffusion . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 42
2.5.3 Diffusion methods . . . . . . . . . . . . . . . . . . . . . . . . . . . 43
2.5.4 Ion implantation . . . . . . . . . . . . . . . . . . . . . . . . . . . . 44
II
Contents
3 Oxidation 48
3.1 Overview . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 48
3.1.1 Application . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 48
3.1.2 Properties of oxide layers . . . . . . . . . . . . . . . . . . . . . . . 48
3.2 Fabrication of oxide layers . . . . . . . . . . . . . . . . . . . . . . . . . . . 49
3.2.1 Thermal oxidation . . . . . . . . . . . . . . . . . . . . . . . . . . . 49
3.2.2 Oxidation by vapor deposition . . . . . . . . . . . . . . . . . . . . 52
3.3 LOCOS process . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 53
3.3.1 Very large-scale integration . . . . . . . . . . . . . . . . . . . . . . 53
3.3.2 Bird’s beak . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 53
3.3.3 Alternative . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 55
3.4 Film thickness measurement . . . . . . . . . . . . . . . . . . . . . . . . . . 55
3.4.1 Metrology . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 55
3.4.2 Interferometry . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 56
3.4.3 Ellipsometry . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 57
3.4.4 Appraisal of the measurement . . . . . . . . . . . . . . . . . . . . 58
4 Deposition 59
4.1 Plasma, the fourth aggregation state of a material . . . . . . . . . . . . . 59
4.1.1 Plasma state . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 59
4.1.2 Plasma generation . . . . . . . . . . . . . . . . . . . . . . . . . . . 60
4.2 Chemical vapor deposition . . . . . . . . . . . . . . . . . . . . . . . . . . 61
4.2.1 Silicon vapor phase epitaxy . . . . . . . . . . . . . . . . . . . . . . 61
4.2.2 CVD process: Chemical Vapor Deposition . . . . . . . . . . . . . . 63
4.2.3 APCVD: Atmospheric Pressure CVD . . . . . . . . . . . . . . . . 64
4.2.4 LPCVD: Low Pressure CVD . . . . . . . . . . . . . . . . . . . . . . 65
4.2.5 PECVD: Plasma Enhanced CVD . . . . . . . . . . . . . . . . . . . 66
4.2.6 ALD: Atomic Layer Deposition . . . . . . . . . . . . . . . . . . . . 67
4.3 Physical deposition methods . . . . . . . . . . . . . . . . . . . . . . . . . 69
4.3.1 Molecular beam epitaxy . . . . . . . . . . . . . . . . . . . . . . . . 69
4.3.2 Evaporating . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 69
4.3.3 Sputtering . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 70
5 Metallization 73
5.1 Requirements on metallization . . . . . . . . . . . . . . . . . . . . . . . . 73
III
Contents
5.2 Aluminum technology . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 74
5.2.1 Aluminum and aluminum alloy . . . . . . . . . . . . . . . . . . . 74
5.2.2 Diffusion in silicon . . . . . . . . . . . . . . . . . . . . . . . . . . . 74
5.2.3 Electromigration . . . . . . . . . . . . . . . . . . . . . . . . . . . . 75
5.2.4 Hillocks . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 76
5.3 Copper technology . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 76
5.3.1 Copper technology . . . . . . . . . . . . . . . . . . . . . . . . . . . 76
5.3.2 Damascene process . . . . . . . . . . . . . . . . . . . . . . . . . . . 77
5.3.3 Low-k technology . . . . . . . . . . . . . . . . . . . . . . . . . . . 81
5.4 Metal semiconductor junction . . . . . . . . . . . . . . . . . . . . . . . . . 84
5.4.1 Metal semiconductor junction . . . . . . . . . . . . . . . . . . . . . 84
5.4.2 Band model of p-n junctions . . . . . . . . . . . . . . . . . . . . . 87
5.5 Wiring . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 88
5.5.1 Wiring . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 88
5.5.2 BPSG reflow . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 88
5.5.3 Reflow back etching . . . . . . . . . . . . . . . . . . . . . . . . . . 88
5.5.4 Chemical mechanical polishing . . . . . . . . . . . . . . . . . . . . 89
5.5.5 Contacting . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 90
6 Photolithographie 91
6.1 Exposure and resist coating . . . . . . . . . . . . . . . . . . . . . . . . . . 91
6.1.1 Overview . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 91
6.1.2 Adhesives . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 91
6.1.3 Coating . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 92
6.1.4 Exposure . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 93
6.1.5 Exposure methods . . . . . . . . . . . . . . . . . . . . . . . . . . . 94
6.2 Exposition methods . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 95
6.2.1 Overview . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 95
6.2.2 Contact exposure . . . . . . . . . . . . . . . . . . . . . . . . . . . . 95
6.2.3 Proximity exposure . . . . . . . . . . . . . . . . . . . . . . . . . . . 95
6.2.4 Projection . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 96
6.2.5 Electron beam lithography . . . . . . . . . . . . . . . . . . . . . . 98
6.2.6 X-ray lithography . . . . . . . . . . . . . . . . . . . . . . . . . . . . 99
6.2.7 Additional methods . . . . . . . . . . . . . . . . . . . . . . . . . . 99
6.3 Photoresist . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 100
6.3.1 Photoresist . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 100
IV
Contents
6.3.2 Chemical composition . . . . . . . . . . . . . . . . . . . . . . . . . 100
6.4 Development and inspection . . . . . . . . . . . . . . . . . . . . . . . . . 101
6.4.1 Development . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 101
6.4.2 Inspection . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 102
6.4.3 Resist removal . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 102
6.5 Photomasks . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 104
6.5.1 Introduction . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 104
6.5.2 Photomask manufacture . . . . . . . . . . . . . . . . . . . . . . . . 104
6.5.3 Photomasks . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 105
6.5.4 Next generation lithography . . . . . . . . . . . . . . . . . . . . . 109
7 Wet chemistry 110
7.1 Etch processes . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 110
7.2 Wet etching . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 111
7.2.1 Principle . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 111
7.2.2 Requirements . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 111
7.2.3 Batch etching . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 112
7.2.4 Spray etching . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 113
7.2.5 Anisotropic etching of silicon . . . . . . . . . . . . . . . . . . . . . 113
7.2.6 Etching solutions for isotropic etching . . . . . . . . . . . . . . . . 114
7.3 Wafer cleaning . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 115
7.3.1 Cleanroom . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 115
7.3.2 Types of contamination . . . . . . . . . . . . . . . . . . . . . . . . 116
7.3.3 Microscopic contamination . . . . . . . . . . . . . . . . . . . . . . 117
7.3.4 Molecular contamination . . . . . . . . . . . . . . . . . . . . . . . 118
7.3.5 Alkaline and metallic contamination . . . . . . . . . . . . . . . . . 118
7.3.6 Cleaning techniques . . . . . . . . . . . . . . . . . . . . . . . . . . 118
8 Dry etching 121
8.1 Overview . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 121
8.1.1 Abstract . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 121
8.1.2 Major values in dry etching . . . . . . . . . . . . . . . . . . . . . . 121
8.1.3 Dry etch processes . . . . . . . . . . . . . . . . . . . . . . . . . . . 122
8.2 Dry etch processes . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 122
8.2.1 Ion Beam Etching . . . . . . . . . . . . . . . . . . . . . . . . . . . . 122
8.2.2 Plasma Etching . . . . . . . . . . . . . . . . . . . . . . . . . . . . . 123
V
Contents8.2.3 Reactive Ion Etching . . . . . . . . . . . . . . . . . . . . . . . . . . 125
电子书籍部分截图:


©软件著作权归作者所有。本站所有软件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处: 芯知社区 » Semiconductor Technology Introduction



发表评论 取消回复